英飛凌(Infineon)近日宣布,該公司在12吋矽功率半導體製造技術方面取得突破性進展,成功製造出目前世界上最薄的矽功率晶圓。其晶圓厚度僅20微米,是目前最先進晶圓厚度的一半,並因此得到電阻值減少50%、系統損耗減少15%的效益。
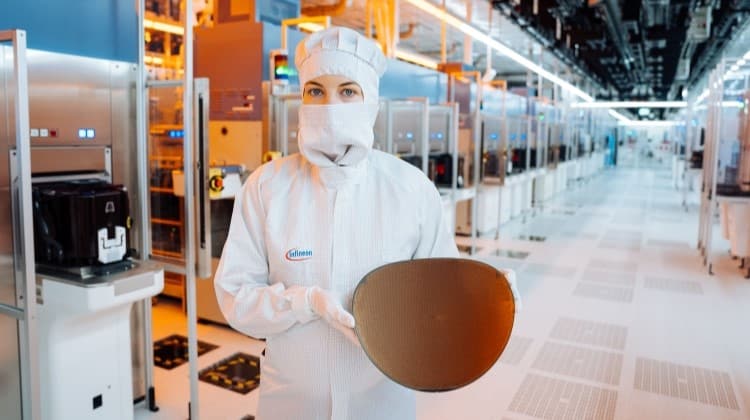
英飛凌執行長Jochen Hanebeck表示,該公司在超薄晶圓技術方面的突破,使得英飛凌在節能功率解決方案領域邁出了重要一步,並且有助於我們充分發揮全球低碳化和數位化趨勢的潛力。這項創新將有助於大幅提高AI資料中心、消費、馬達控制和運算應用中,功率轉換解決方案的能源效率、功率密度和可靠性。由於晶圓厚度減少了一半,基板電阻較原本基於40~60微米厚的傳統矽晶圓解決方案降低了50%,因此電源系統中的功率損耗可減少15%以上。
以資料中心電源為例,對高階AI伺服器應用來說,降低電阻是非常重要的課題。由於採用先進製程生產的緣故,新一代伺服器CPU跟GPU的工作電壓普遍已經降低到1.8V、甚至1V以下,導致為這類元件供電的電源轉換器必須具備支援高達數百A峰值電流的能力,才能為處理器提供足夠電源。然而,在電流增大的同時,若不設法降低電阻,會使電源在傳輸過程中出現巨大損耗。超薄晶圓技術大大促進了基於垂直溝槽MOSFET技術的垂直功率傳輸設計。這種設計實現了與AI晶片處理器的高度緊密連接,在減少功率損耗的同時,提高了整體效率。
英飛凌電源與感測系統事業部總裁Adam White表示,超薄晶圓技術讓英飛凌能以最節能的方式,為各種AI伺服器提供動力。而且這項技術不只能應用在為處理器供電的負載點(POL)電源上,資料中心內的配電,甚至電網端都可以受益。隨著AI資料中心的能源需求大幅上升,效率變得日益重要。這為英飛凌帶來了快速發展的機會,英飛凌預期,在未來兩到三年內,與AI有關的電源產品業務規模,將達到10億歐元。
由於將晶片固定在晶圓上的金屬疊層厚度大於20微米,因此,為了克服將晶圓厚度降低至20微米的技術障礙,英飛凌的工程師們必須建立一種創新而獨特的晶圓研磨方法。同時,超薄晶圓會帶來許多問題,例如晶圓會更容易翹曲、晶圓在傳送與分離過程中更容易破片等,對晶圓穩定性和後段封裝製程產生重大影響。因此,英飛凌的工程團隊不僅開發出新的研磨方法,同時也發展出一系列配套措施,確保超薄晶圓能夠在不增加製造成本並保證產量最大化和供應安全的情況下,無縫整合到現有的矽晶圓量產產線中。
該技術已獲得客戶認可,並被應用於英飛凌的整合智慧功率級(DC-DC轉換器)中。隨著超薄晶圓技術的發展,英飛凌預計在未來三到四年內將取代現有的傳統晶圓技術用於低壓功率轉換器。這項突破進一步鞏固了英飛凌在市場上的獨特地位。英飛凌目前擁有全面的產品和技術組合,覆蓋了基於Si、SiC和GaN的元件,這些元件是推動低碳化和數位化的關鍵因素。