美商科磊(KLA-Tencor)宣布推出兩款全新缺陷檢測產品,在矽晶圓和晶片製造領域中針對尖端邏輯和記憶體節點,為設備和製程監控解決兩個關鍵挑戰。Voyager 1015系統提供了檢測圖案化晶圓的新功能,包括在光阻顯影後並且晶圓尚可重做的情況下,立即在微影單元中進行檢查。Surfscan SP7系統為裸晶圓、平滑和粗糙的薄膜提供了缺陷檢測靈敏度,這對於製造用於7nm邏輯和高級記憶體器件節點的矽基底相當重要,同時也是在晶片製造中及早發現製程問題的關鍵。這兩款新的檢測系統都旨在通過從根源上捕捉缺陷偏移。
KLA-Tencor資深副總裁兼首席營銷官Oreste Donzella說,在IC技術中晶圓和晶片製造商幾乎沒有出錯的空間,新一代晶片的臨界線寬非常小以至於在裸矽晶片或覆膜監測晶圓上,那些可以導致良率損失的缺陷尺寸已經小於現有設備監測系統的檢測極限。此外,無論是193i還是EUV,缺陷檢測領域的第二個關鍵是如何可靠地檢測到微影製程早期所引入的良率損失缺陷。該公司的工程團隊開發出兩種新的缺陷檢測系統:一種用於無圖案/控片晶圓,一種用於圖案化晶圓,為工程師快速並準確地解決這些難題。














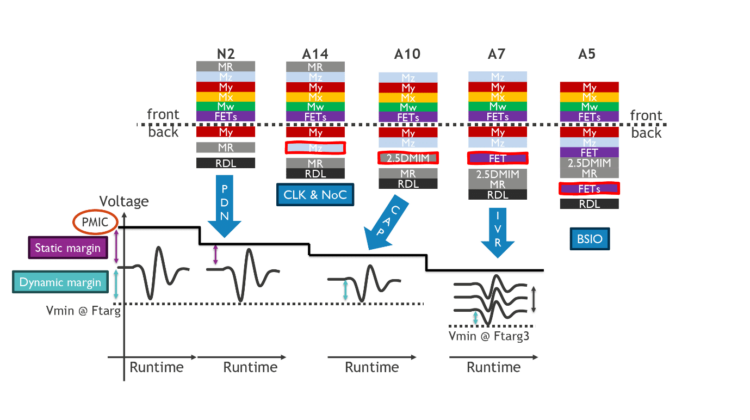











雷射,可穿透矽晶圓和無機層釋放材質,能在奈米級精度下利用IR雷射,從矽載具釋放任何超薄的薄膜。-e1663234325608.jpg)